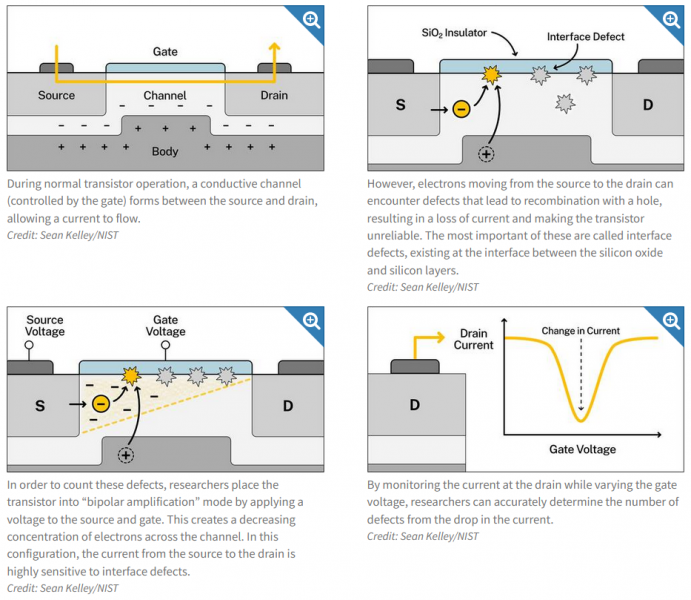
Onderzoekers van het National Institute of Standards and Technology (NIST) en de Pennsylvania State University hebben een nieuwe, zeer gevoelige methode bedacht en getest voor het detecteren en tellen van defecten in transistors.
De resultaten zijn gepubliceerd in het Journal of Applied Physics.
Een typische transistor is voor de meeste toepassingen in feite een schakelaar. De prestatie hangt in grote mate af van hoe betrouwbaar een bepaalde hoeveelheid stroom zal vloeien. Defecten in het transistormateriaal, zoals ongewenste onzuiverheden of verbroken chemische bindingen, onderbreken en destabiliseren de stroom. Deze defecten kunnen zich onmiddellijk of gedurende een langere periode manifesteren terwijl het apparaat in bedrijf is.
Gedurende vele jaren hebben wetenschappers talloze manieren gevonden om die effecten te classificeren en te minimaliseren. Maar defecten worden moeilijker te identificeren omdat de afmetingen van de transistor bijna onvoorstelbaar klein worden en de schakelsnelheden erg hoog. Voor sommige veelbelovende halfgeleidermaterialen in ontwikkeling – zoals siliciumcarbide (SiC) in plaats van alleen silicium (Si) voor nieuwe apparaten met hoge energie en hoge temperaturen – was er geen eenvoudige en duidelijke manier om defecten in detail te karakteriseren.
"De methode die we hebben ontwikkeld, werkt met zowel traditioneel Si als SiC, waardoor we voor het eerst niet alleen het type defect kunnen identificeren, maar ook het aantal ervan in een bepaalde ruimte met een eenvoudige DC-meting", zegt James Ashton.
Het onderzoek richt zich op interacties tussen de twee soorten elektrische ladingsdragers in een transistor: negatief geladen elektronen en positief geladen ‘gaten’, dit zijn ruimtes waar een elektron ontbreekt in de lokale atomaire structuur.
Wanneer een transistor correct functioneert, vloeit er een specifieke elektronenstroom langs het gewenste pad. (Gaten kunnen ook een stroom vormen. Dit onderzoek onderzocht elektronenstroom, de meest voorkomende opstelling.) Als de stroom een defect tegenkomt, worden elektronen opgesloten of verplaatst, en kunnen ze vervolgens worden gecombineerd met gaten om een elektrisch neutraal gebied te vormen in een proces dat bekend staat als recombinatie.
Elke recombinatie verwijdert een elektron uit de stroom. Meerdere defecten veroorzaken stroomverliezen die tot storingen leiden. Het doel is om te bepalen waar de defecten zich bevinden, hun specifieke effecten en – idealiter – het aantal ervan.
"We wilden fabrikanten een manier bieden om defecten te identificeren en te kwantificeren terwijl ze verschillende nieuwe materialen testen", zegt co-auteur Jason Ryan. "We hebben dat gedaan door een natuurkundig model te maken van een defectdetectietechniek die tot nu toe veel wordt gebruikt maar slecht wordt begrepen. Vervolgens voerden we proof-of-principle-experimenten uit die ons model bevestigden."
In een klassiek metaaloxide-halfgeleiderontwerp (zie afbeelding) wordt een metalen elektrode, de poort genaamd, bovenop een dunne isolerende siliciumdioxidelaag geplaatst. Onder die interface bevindt zich het bulklichaam van de halfgeleider.
Aan de ene kant van de poort bevindt zich een ingangsklem, de bron genoemd; aan de andere kant is een uitgang (afvoer). Wetenschappers onderzoeken de dynamiek van de stroom door de ‘bias’-spanningen die op de gate, source en drain worden toegepast te veranderen, die allemaal van invloed zijn op hoe de stroom beweegt.
De grens tussen oxide en bulk
De onderzoekers concentreerden zich op één bepaald gebied dat typisch slechts ongeveer 1 miljardste van een meter dik en een miljoenste van een meter lang is: de grens, of het kanaal, tussen de dunne oxidelaag en het bulkhalfgeleiderlichaam.
"Deze laag is enorm belangrijk omdat het effect van een spanning op het metaal boven op het oxide van de transistor het aantal elektronen in het kanaalgebied onder het oxide verandert; deze regio regelt de weerstand van het apparaat van bron tot afvoer, "zei Ashton. "De prestatie van deze laag is afhankelijk van het aantal defecten. Met de door ons onderzochte detectiemethode kon voorheen niet worden vastgesteld hoeveel defecten zich binnen deze laag bevonden."
Een gevoelige methode om defecten in het kanaal te detecteren, is elektrisch gedetecteerde magnetische resonantie (EDMR). In EDMR wordt de transistor bestraald met microgolven met een frequentie die ongeveer vier keer hoger is dan die van een magnetron. Onderzoekers passen een magnetisch veld toe op het apparaat en variëren geleidelijk de sterkte terwijl ze de uitgangsstroom meten.
Bij precies de juiste combinatie van frequentie en veldsterkte keren elektronen bij defecten hun polen om. Dit zorgt ervoor dat sommigen genoeg energie verliezen om te recombineren met gaten bij defecten in het kanaal, waardoor de stroom afneemt. De kanaalactiviteit kan echter moeilijk te meten zijn, vanwege het hoge volume aan ‘ruis’ van recombinatie in het grootste deel van de halfgeleider.
Om zich uitsluitend op activiteit in het kanaal te concentreren, gebruiken onderzoekers bipolair amplificatie-effect (BAE), dat wordt bereikt door de voorspanningen die op de source, gate en drain worden toegepast in een bepaalde configuratie te rangschikken (zie afbeelding). Ashton: "Dus vanwege de bias die we gebruiken in BAE en omdat we stroomniveaus aan de afvoer meten, kunnen we interferentie elimineren van andere dingen die in de transistor gebeuren. We kunnen de defecten uitkiezen die we belangrijk vinden."
Het exacte mechanisme waarmee BAE werkt, was niet bekend totdat het team zijn model ontwikkelde. "De enige meetresultaten waren kwalitatief – dat wil zeggen, ze konden het soort defecten in het kanaal vertellen, maar niet het aantal", zei co-auteur Patrick Lenahan.
Vóór het model van BAE werd het schema uitsluitend gebruikt als hulpmiddel voor het toepassen van spanningen en het regelen van stromen voor EDMR-metingen, wat nuttig is voor een meer kwalitatieve identificatie van defecten. Het nieuwe model stelt BAE als hulpmiddel in staat om het aantal defecten kwantitatief te meten en dit te doen met alleen stromen en spanningen. De parameter van belang is de dichtheid van het grensvlakdefect, dat een getal is dat beschrijft hoeveel defecten zich binnen een bepaald gebied van het halfgeleider-oxide-grensvlak bevinden. Het BAE-model geeft onderzoekers een wiskundige beschrijving van hoe de BAE-stroom is gerelateerd aan de defectdichtheid.
Het model, dat de onderzoekers testten in een reeks proof-of-concept-experimenten op metaaloxide-halfgeleidertransistors, maakt kwantitatieve metingen mogelijk. "Nu kunnen we rekening houden met de variatie in de distributie van ladingdragers in het kanaalgebied", zei Ashton. "Dit opent de mogelijkheden van wat kan worden gemeten met een eenvoudige elektrische meting."
"Deze techniek kan een uniek inzicht geven in de aanwezigheid van deze destabiliserende transistordefecten en een pad naar mechanistisch begrip van hun vorming", zegt Markus Kuhn, voorheen bij Intel en nu senior directeur van halfgeleidermetrologie en fellow bij Rigaku, die niet betrokken was bij het onderzoek. "Met dergelijke kennis zouden er meer mogelijkheden zijn om ze te beheersen en te verminderen om de prestaties en betrouwbaarheid van de transistor te verbeteren. Dit zou een kans zijn om het ontwerp van de chipcircuits en de apparaatprestaties verder te verbeteren, wat leidt tot beter presterende producten."




